隨着技術的不斷進步,SiC IGBT器件的封裝材料進一步優化,以滿足更嚴苛的應用需求,推動電力電子裝備向高效化、小型化方向發展?。近日,第十屆國際第三代半導體論壇&第二十一屆中國國際半導體照明論壇(IFWS&SSLCHINA2024)在蘇州召開。

期間,「碳化硅功率器件及其封裝技術 I」分會上,北京康美特科技股份有限公司研發總監龐凱敏帶來了「高可靠性碳化硅基IGBT器件封裝材料」的主題報告,分享了灌封材料的性能要求、灌封材料的選擇、環氧灌封膠設計等內容。

龐凱敏
北京康美特科技股份有限公司研發總監
碳化硅IGBT器件灌封材料的選擇對其性能和壽命有着至關重要的影響。高功率密度需求催生封裝材料和工藝不斷選代。高可靠性IGBT灌封膠具有耐高溫、耐高壓、機械強度-高低溫循環等性能要求。報告顯示,環氧灌封膠設計技術難點涉及低膨脹係數與低模量間難以平衡的矛盾,高填充體系的高黏度難題,高填充材料普遍面臨粘接強度不足的挑戰。為了提高環氧灌封膠的韌性,可以在環氧機體中引入增韌劑,或通過分子結構設計引入柔性鏈段。
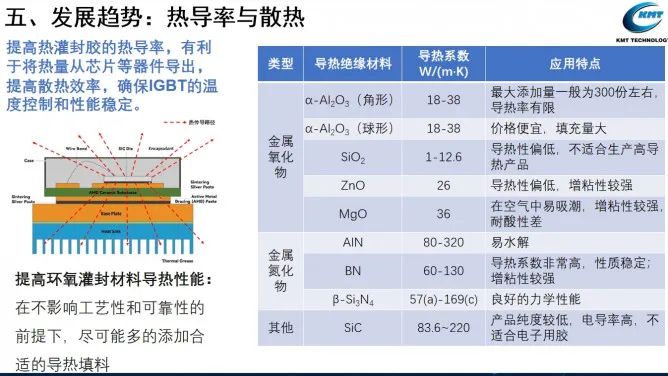

提高熱灌封膠的熱導率,有利於將熱量從芯片等器件導出,提高散熱效率,確保IGBT的溫度控制和性能穩定。提高環氧灌封材料導熱性能,在不影響工藝性和可靠性的前提下,儘可能多的添加合適的導熱填料。
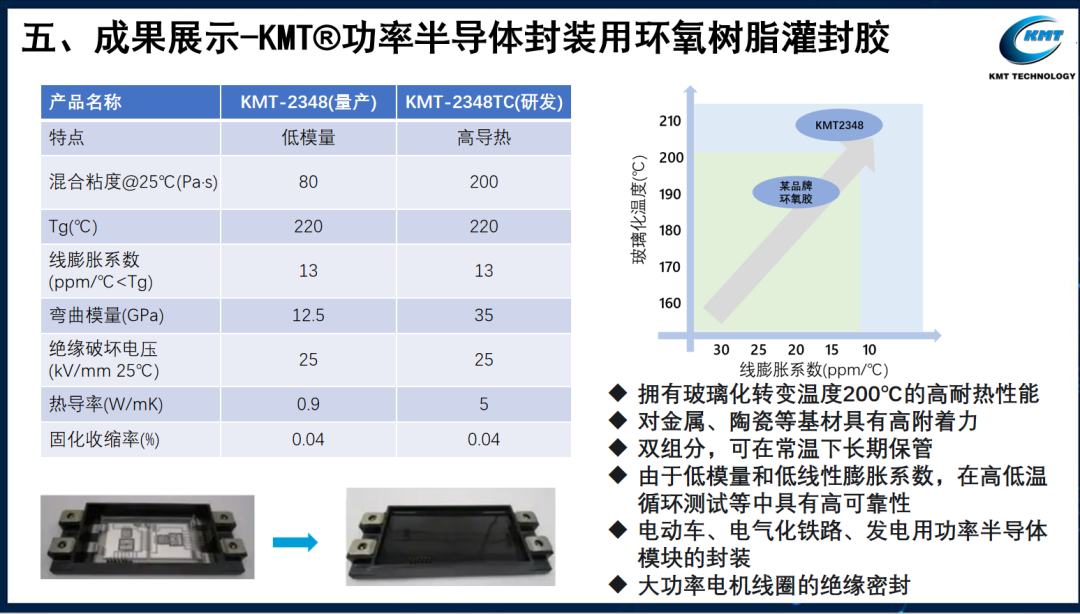
報告指出,通過材料結構和組成優化,設計製備出可以滿足現有SiC功率器件灌封用的環氧樹脂灌封膠。SiC功率器件用的環氧灌封膠的耐熱性和耐高低溫衝擊等性能,有待進一步提升。
(根據現場資料整理,僅供參考)
附:IFWS&SSLCHINA2024論壇介紹

2024年11月18-21日,第十屆國際第三代半導體論壇&第二十一屆中國國際半導體照明論壇(IFWS&SSLCHINA2024)在蘇州召開。本屆論壇由蘇州實驗室、第三代半導體產業技術創新戰略聯盟(CASA)、中關村半導體照明工程研發及產業聯盟(CSA)主辦,國家第三代半導體技術創新中心(蘇州)(NCTIAS)、江蘇第三代半導體研究院、北京麥肯橋新材料生產力促進中心有限公司承辦。來自政、產、學、研、用、資等LED及第三代半導體產業領域國內外知名專家、企業高管、科研院所高校學者,共計2100餘名代表註冊參會。通過大會、16場主題技術分論壇、5場熱點產業峯會、4場強芯沙龍會客廳主題對話、以及第六屆先進半導體技術應用創新展(CASTAS)、POSTER展示交流等多種形式的活動,在近30個專題活動、230餘個主題報告,台上台下展開探討,從不同的角度分享前沿技術進展,交流探討,觀點碰撞,探求技術與產業化融合創新與發展之道。
IFWS&SSLCHINA2024論壇上還公布了「2024年度中國第三代半導體技術十大進展」和「9項 SiC MOSFET測試與可靠性標準」。為行業發展做出了積極貢獻的企業/單位頒發了2024年度推薦品牌獎。本屆論壇共收到260餘篇論文投稿,論壇與IEEE合作,投稿的錄取論文會被遴選在IEEE Xplore 電子圖書館發表。現場展示116篇POSTER海報。經過程序委員會專家,以及參會人的投票,評選出了10篇最佳POSTER獎。在大會閉幕總結儀式現場,現場頒發了最佳POSTER一、二、三等獎及優秀海報獎。
(轉自:第三代半導體產業)